石墨烯的优异性能在实际应用中常因CVD制备过程中产生的点缺陷和非晶碳污染而大幅受限。现有研究多聚焦于污染去除或缺陷修复的单独问题,但二者的关联机制仍不清晰,也缺乏能同时实现清洁与修复的有效策略。此外,氧在石墨烯生长及缺陷修复中的具体作用长期存在争议,仍有待系统阐明。因此,本研究提出了一种痕量氧辅助的后处理策略,通过精准调控氧气的引入,同步实现石墨烯表面非晶碳污染的高效去除与晶格缺陷的快速修复。研究结合第一性原理计算与系统实验验证,揭示了氧气在蚀刻非晶碳和降低缺陷修复能垒方面的双重作用机制,成功将Stone-Wales缺陷的修复能垒从2.84 eV显著降低至0.36 eV。所制备的石墨烯薄膜展现出接近理想单晶的结构完整性,其二维杨氏模量高达355 N·m-1,断裂强度达1778 nN,电学性能方面更是实现了174.4 ± 31.9Ω·sq-1的低方阻和室温下超15000 cm2·V-1·s-1的载流子迁移率。该工作不仅阐明了氧气在高质量石墨烯合成中的新功能,也为面向高性能电子器件的大规模石墨烯制备提供了一条简单而有效的技术路径。
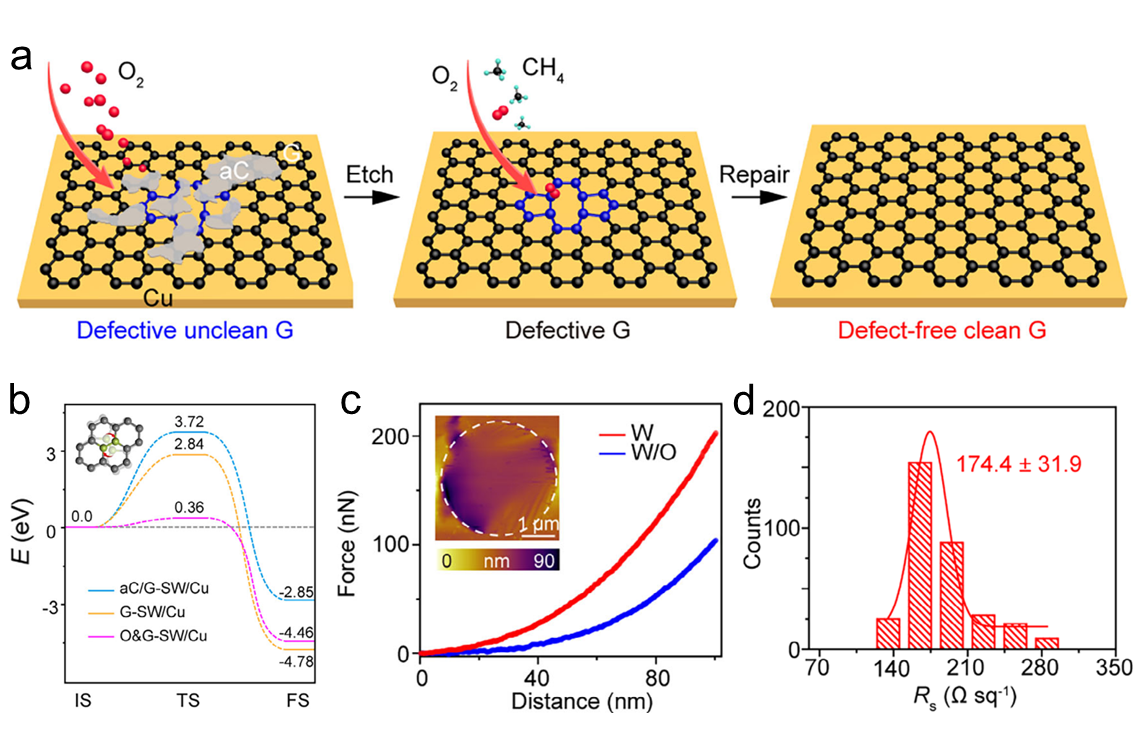
图:痕量氧辅助制备高质量石墨烯薄膜。a)痕量氧刻蚀无定形碳并促进缺陷修复示意图。b)理论计算不同结构的修复能垒,氧气存在时结构转变所需的能量最小。c)未处理(蓝色)与处理后(红色)石墨烯薄膜的力-位移曲线,经过处理后的石墨烯力学性能更强。d)经过处理后石墨烯的方块电阻直方图统计结果。
